2.3DIC集成技术简介
如图1b所示,在2.3DIC集成工艺中,精细金属线宽/线距(L/S)重分布层(RDL)基板(或有机转接板)与积层封装基板或高密度互连(HDI)板采用分开制造的方式,两者完成各自制备后,通过焊点实现互连,并采用底部填充料进行保护,最终形成混合基板结构。得益于临时玻璃晶圆/面板的辅助制造工艺,精细金属L/S基板能够实现2μm的线宽/线距规格,同时保持较高的生产良率。正是这种工艺优势,使得2.3DIC集成的互连密度高于2.1DIC集成。

目前,有机转接板的制备方法至少有3种,具体分别为:①传统半加成工艺(semi-additive process,SAP)/印刷电路板(PCB)方法;②先上晶扇出型方法;③后上晶扇出型方法。表1对这3种制备方法进行了全面对比,从对比结果中可得出以下结论:①由于需要额外进行晶圆凸点制备、芯片与RDL基板键合以及底部填充等工序,SAP/PCB方法和后上晶扇出型方法的成本相对高于先上晶扇出型方法;②从承载能力来看,SAP/PCB方法和后上晶扇出型方法能够承载更大尺寸的芯片以及更大规格的封装结构;③在精细度方面,后上晶扇出型方法可实现RDL基板最小的金属线宽/线距(L/S)。

SAP/PCB方法
2026
神钢(Shinko)株式会社研发了无芯板有机转接板,2012年该公司提出采用无芯板封装基板替代硅通孔(TSV)转接板,具体结构如图2所示。可以明确的是,无芯板有机转接板的制造成本远低于TSV/RDL转接板,但该类型转接板的翘曲控制一直是生产过程中的技术难题。

思科(Cisco)公司也开发了专属有机转接板,图3所示为该公司设计的基于大尺寸有机转接板(无TSV结构),结合窄节距、窄线宽互连工艺制造的芯粒及异质集成封装结构。该有机转接板尺寸为38mm×30mm×0.4mm,共包含12层结构,具体分层为5层顶部走线层、2层芯板层和5层底部走线层(5-2-5结构);与之搭配的封装基板尺寸为50mm×50mm,共包含4层结构,分别为1层顶部走线层、2层芯板层和1层底部走线层(1-2-1结构)。有机转接板正面与背面的最小金属线宽(L)、线距(S)及金属层厚度完全一致,分别为6μm、6μm和10μm;转接板(基板)共计10层走线层,内部通孔尺寸为20μm。在封装布局上,1颗尺寸为19.1mm×24mm×0.75mm的专用集成电路(application-specific integrated circuit,ASIC)芯片,与另外4颗由动态随机存取存储器(dynamic random-access memory,DRAM)堆叠形成的高带宽存储器(high bandwidth memory,HBM)共同搭载于有机转接板上方。单颗3D HBM芯片尺寸为5.5mm×7.7mm×0.48mm,由1颗底部缓冲芯片和4颗DRAM核芯片组成,芯片之间通过硅通孔(through silicon via,TSV)及带有焊料帽的窄节距微凸点实现互连;有机转接板正面焊盘尺寸为30μm,焊盘节距为55μm。

先上晶扇出型方法
2026
2013年,星科金朋(Stats ChiPAC)提出采用先上晶扇出型倒装芯片(fan-out chip-first flip-chip, FOFC)技术——即嵌入式晶圆级焊球阵列(embedded wafer level ball grid array, eWLB)技术,在芯片表面直接制作RDL,以此实现芯片大部分横向与纵向通信功能。根据相关专利(U.S.9484319B2,2011年12月23日提交)描述,该技术的核心目的是采用RDL(无芯有机转接板)替代传统的TSV转接板、微凸点及底部填充料,该专利于2016年11月1日正式获得授权。此后,联发科(MediaTek)、日月光(ASE)和台积电(TSMC)等企业均开展了相关技术的研发工作。图4所示为日月光研发的扇出型板上芯片(fan-out chip-on-substrate,FOCoS)技术,该技术先在临时晶圆承载片上采用先上晶且面朝下的方式实现扇出,随后通过模压环氧模塑料(epoxy molding compound,EMC)完成包封工艺。

后上晶扇出型方法
2026
目前已有多家企业开展后上晶(或先上RDL)方法的研发,旨在制备精细金属L/S RDL基板(或有机转接板),以替代TSV转接板实现2.3DIC集成,其中包括矽品科技(SPIL)、三星(Samsung)、日月光(ASE)、台积电(TSMC)、神钢(Shinko)及欣兴电子(Unimicron)等。多数企业在制造RDL基板时,均会采用临时晶圆作为支撑片。例如,图5和图6分别为三星和日月光的2.3DIC集成结构,两者的RDL基板均制备于临时晶圆支撑片上;图7和图8为欣兴电子的2.3DIC集成结构,其RDL基板则制备于临时面板支撑片上,该类型支撑片的产率高于临时晶圆支撑片。

精细金属L/S基板与积层封装基板或高密度互连(HDI)基板,同样可与互连层进行搭配使用,这一应用方式与相关研究报道所述基本一致,核心区别在于采用互连层替代了传统的焊点和底部填充料,具体结构如图9所示。

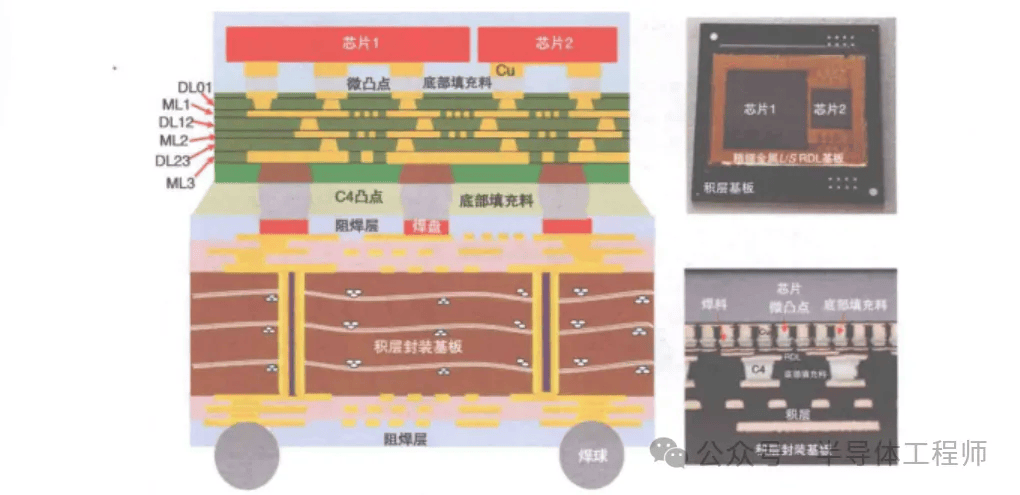

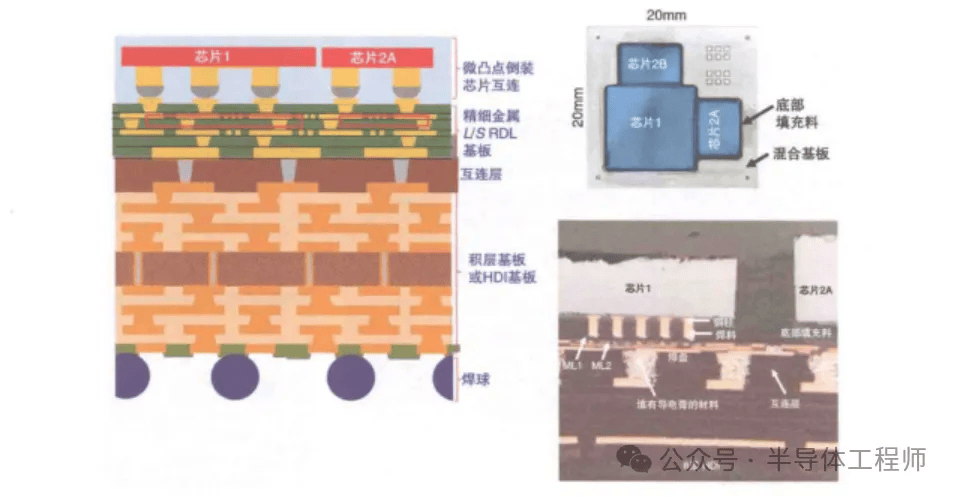
来源于学习那些事,作者前路漫漫